+更多分类
 |
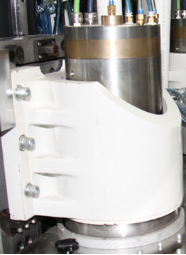

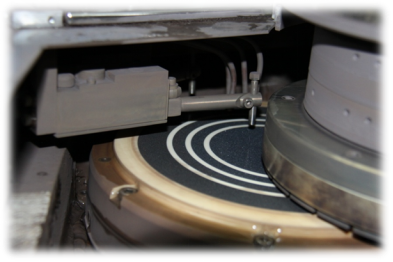
晶圆直径 |
| mm | Max.ø200(ø4" - ø8") |
磨削方式 |
|
| In-feed grinding with wafer rotation 通过旋转晶圆,实现纵向切入式磨削 |
主轴 | 使用主轴 | - | 高频电机内装式空气主轴 |
主轴数量 | - | 2 | |
额定功率 | Kw | 3.8 | |
转速 | Rpm | 1000-6000 | |
Z轴行程 | mm | 90(有初始化位置) | |
Z轴进给速度 | mm/s | 0.00001~0.08 | |
Z轴快速退刀速度 | mm/s | 50 | |
Z轴最小位移量 | μm | 0.1 | |
Z轴分辨率 | μm | 0.1 | |
测量仪 | 测量范围 | μm | 0 - 1,600 |
分辨率 | μm | 0.1 | |
重复精度 | μm | ±0.5 | |
承片台 | 承片台轴类型 |
| 空气轴承 |
承片台类型 |
| 多孔陶瓷式承片台 | |
装片方式 |
| 真空吸附 | |
转速 | rpm | 0-300 | |
承片台数 |
| 3 | |
加工精度 | 单片晶圆內的厚度偏差 | μm | 1.5以下(使用专用承片台) |
不同片晶圆內的厚度偏差 | μm | ±3以下 | |
精磨粗糙度 | μm | Ry 0.13(使用#2000磨輪進行精加工時) Ry 0.15(使用#1400磨輪進行精加工時) | |
晶圆磨削最小厚度 |
| μm | 最小厚度100mm |
碎片率 |
|
| 1/1000(在粗磨采用325#、精磨采用2000#砂轮,目标厚度不小于150μm的情况下) |