Octopus系列高密度IC倒装芯片高速高精度装贴设备,在3D封装、WLP Fan-out技术、多芯片堆叠技术及Panel级Fan-out技术等先进封装工艺上获得了广泛应用。目前已形成Chip to Wafer、Chip to Panel和Chip to Substrate三种机型产品,并已批量向国内龙头封装企业提供。
关键部件
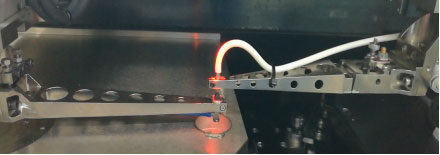 1、预处理机构
1、预处理机构独有的芯片传输机构(专利保护),大幅缩短芯片从蓝膜到基料的传输距离,提升芯片生产效率。
 2、全自动上下料系统
2、全自动上下料系统1.Wafer ring自动上下料,Bar code识别,智能制造;
2.Base wafer自动上下料,进口机械手,Notch对准机构Aligner实现高稳定性。
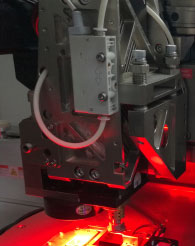 3、键合头
3、键合头高效键合头系统,程控键合压力,保证bump压平高度;翻转头同样具备压力可控功能。
 4、软件界面
4、软件界面1.清晰明了的BEE软件界面设计,树形结构引导操作;
2.Post Bond 精度曲线实时显示;
3.方便快捷芯片模板制作,预对准校正功能。
关键特点
◎ 软件可根据工艺要求设置装片区域、颗数,实现无图谱的盲贴功能。
◎ 操作方便,易于维护,全自动上下料。
◎ 芯片倒装工艺程序Recipe保存提取,提升操作效率。
◎ Bond head和Flux cavity调平方式简单易用。
◎ Tool的使用寿命可以在机器里面进行设置,达到机器设定值后会报警,Post Bond Inspection报警纪录,可全部检查并记录而不影响效率。
◎ 墨点、崩边、裂片和脏污等缺陷芯片检测。
◎ 可去除翻转功能,实现正装芯片键合生产。
技术参数
型号 | Octopus-1300 | Octopus-ST1300 | Octopus-PL1300 | ||||
上料晶圆 | 8"/12" | ||||||
芯片尺寸 | 长:0.5~25mm 宽:0.5~25mm 厚:≥50μm | ||||||
基料 | C2W晶圆 8"/12" | 基板/mm | Panel 面板/mm | ||||
L | W | D | L | W | D | ||
50~350 | 50~200 | 0.1~4 | 650 | 650 | 0.1~1 | ||
助焊剂模块 | √ | √ | 可选 | ||||
自动上下料 | √ | √ | 手动下料 | ||||
设备尺寸 L×W×H/mm | 2250×1540×1790 | 2600×1800×1700 | 3300×1670×1700 | ||||
设备重量/Kg | 2700 | ||||||
交货期 | 10周 | 10周 | 12周 | ||||
设备性能(Performance) | ||
UPH | 6,000(Dry run,不同芯片和贴装精度要求,UPH会不同) | |
X-Y贴装精度 | ±6μm@3σ | |
角度精度 | ±0.1°@3σ | |
键合压力 | 0.5N~30N(程序控制精度0.1N),误差±5% | |
动力设施(Power) | ||
电压 | 3相380V/50~60Hz | |
功耗 | 3kW | |
压缩空气 | 0.6MPa | |
真空 | -75kPa | |





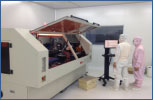




 查看手机站
查看手机站

